Skip to content
Overview
- Economically priced yet fully featured Critical Dimension Standard for calibration over a wide measurement range
- Two scale ranges
- 2.0mm to 1.0 micrometer for desktop SEMs, light microscopes, etc.
- Optional 500nm, 250nm and 100nm gratings for high-resolution FE-SEMs
- Combination of 50nm chrome for larger features and 20nm chrome with 50nm gold for high-resolution features to give increased contrast
- Unique serial identification number for each die
- NIST Traceable
- Available with Global Certificate of Calibration using the average data measured for each production wafer
- Also available with an Individual Die Certificate of Calibration for higher accuracy
Example 2.5×2.5mm die
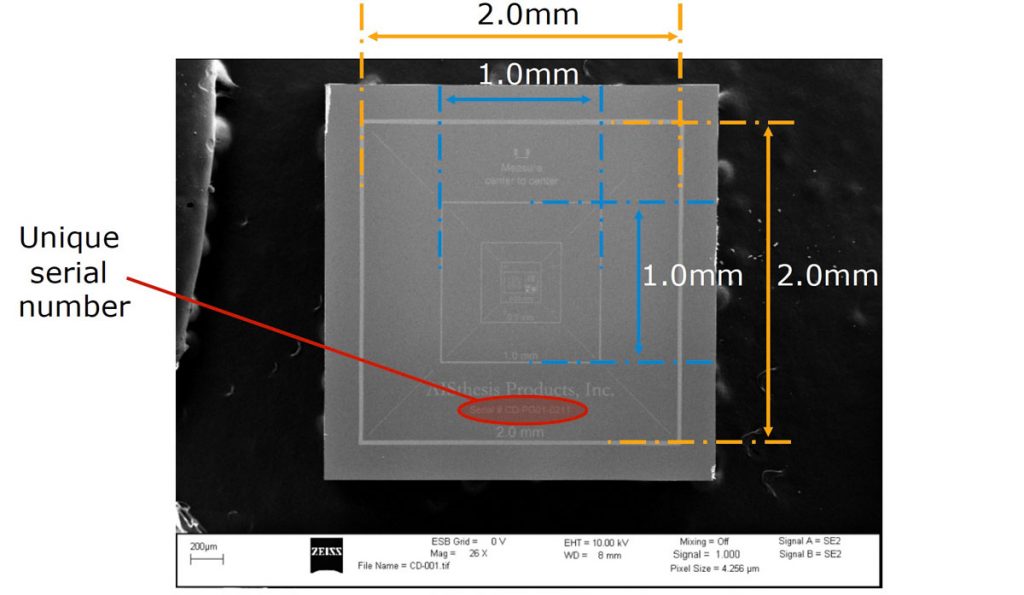
Low Magnification Calibration
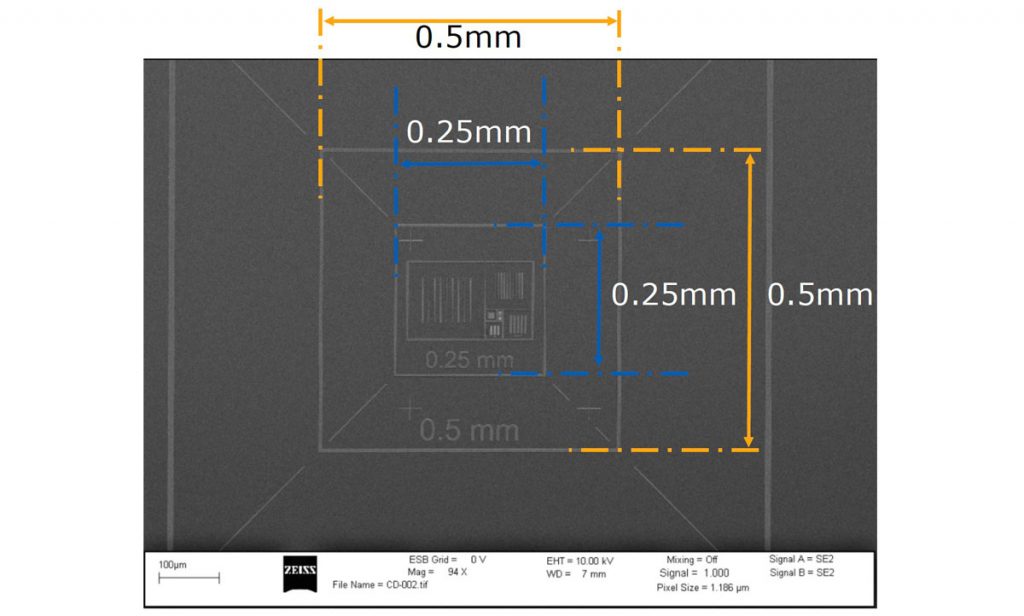
Medium Resolution Lines
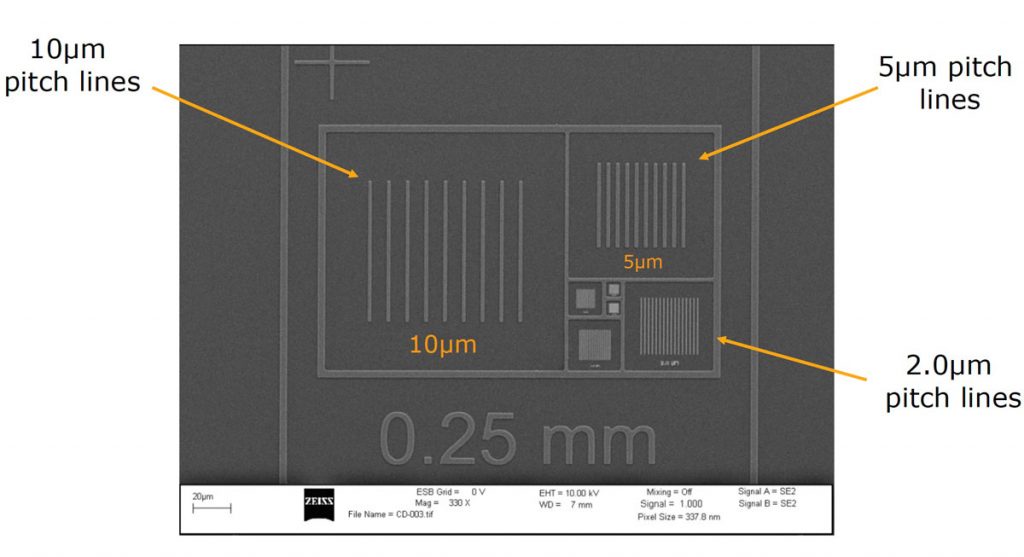
Higher Resolution Lines

500nm, 250nm and 100nm Lines (Only Available on High-Resolution CD Standard)
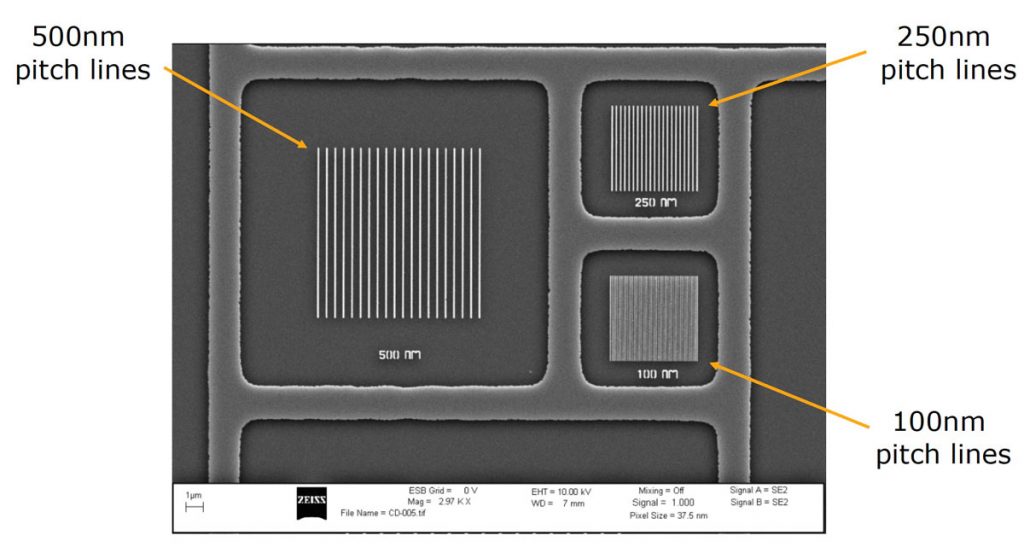
Example of 100nm Line Pitch Measurement